반도체를 외부환경으로부터 보호하고, 전기적으로 연결해주는 패키징 (Packaging) 공정
전공정을 통해 완성된 웨이퍼의 반도체 칩은 낱개로 하나하나 잘라내는데, 이렇게 잘린 칩을 베어칩(bare chip) 또는 다이(die)라고 합니다. 그러나 이 상태의 칩은 외부와 전기신호를 주고받을 수 없으며, 외부 충격에 의해 손상되기 쉬운데요. 반도체 칩, 즉 집적회로(IC)가 기판이나 전자기기에 장착되기 위해선 그에 맞는 포장이 필요합니다. 이와 같이 반도체 칩이 외부와 신호를 주고 받을 수 있도록 길을 만들어주고 다양한 외부환경으로부터 안전하게 보호받는 형태로 만드는 과정을 ‘패키징(Packaging)’이라고 합니다.
패키징은 집적회로와 전자기기를 연결하고 고온, 고습, 화학약품, 진동/충격 등의 외부환경으로부터 회로를 보호하기 위한 공정입니다.
1) 웨이퍼 절단

먼저, 웨이퍼를 낱개의 칩으로 분리해야 합니다. 웨이퍼에는 수백 개의 칩이 촘촘히 배열되어 있고, 각 칩은 스크라이브 라인(Scribe Line)으로 구분되어있는데요. 이 스크라이브 라인을 따라 웨이퍼를 다이아몬드 톱이나 레이저 광선을 이용해 절단합니다. 웨이퍼 절단 작업은 웨이퍼를 톱질하고 잘라낸다는 의미에서 ‘웨이퍼 소잉(Wafer Sawing)’이나, ‘다이싱(Dicing)’이라 불립니다.
2) 칩 접착(Die attach)

절단된 칩들은 리드프레임(Lead Frame) 또는 PCB(Printed Circuit Board) 위에 옮겨집니다. 리드프레임은 반도체 칩과 외부 회로 간 전기신호를 전달하고, 외부 환경으로부터 칩을 보호, 지지해주는 골격 역할을 합니다.
3) 금선 연결
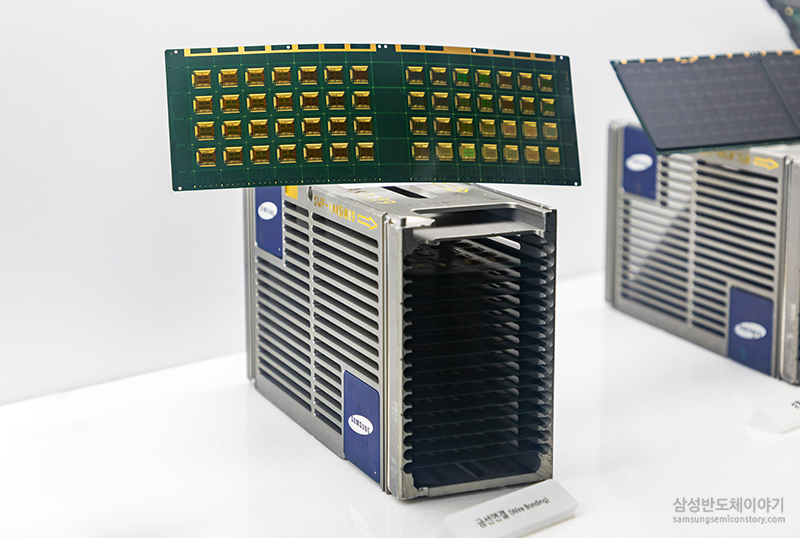
반도체의 전기적 특성을 위해 기판 위에 올려진 반도체 칩의 접점과 기판의 접점을 가는 금선을 사용하여 연결하는 공정을 와이어본딩(Wire Bonding)이라고 합니다.

전통적인 와이어본딩 방식 외에 반도체의 속도를 향상시키기 위해 칩의 회로와 기판을 직접 볼 형태의 범프(Bump, 돌기)로 연결하는 패키징 방식도 있는데요. 플립칩(Flip Chip) 패키지라고 불리는 이 기술은 와이어본딩보다 전기 저항이 작고 속도가 빠르며, 작은 폼팩터(Form Factor) 구현을 가능하게 합니다. 범프의 소재로는 주로 금(Au) 또는 솔더(Solder, 주석/납/은 화합물)가 사용됩니다.
4) 성형(Molding) 공정

금속 연결 공정까지 끝나면 열, 습기 등의 물리적인 환경으로부터 반도체 집적회로를 보호하고, 원하는 형태의 패키지로 만들기 위한 성형(Molding) 공정을 거칩니다. 금선 연결까지 끝난 반도체 칩을 화학 수지로 밀봉하는 공정을 거치면 우리가 흔히 보는 반도체가 됩니다.
완벽한 반도체 제품을 위한 최종 관문, 패키지 테스트(Package Test)

드디어 일상 생활 속에서 만나볼 수 있는 반도체의 모습이 완성되었습니다. 패키징 공정이 완료되면 반도체 제품의 최종 불량유무를 선별하는 패키지 테스트(Package Test)를 시행합니다. 이 테스트는 완제품 형태를 갖춘 후에 검사를 진행하기 때문에 ‘파이널 테스트(Final Test)’라고도 하는데요.
패키지 테스트는 반도체를 검사장비(Tester)에 넣고 다양한 조건의 전압이나 전기신호, 온도, 습도 등을 가해 제품의 전기적 특성, 기능적 특성, 동작 속도 등을 측정합니다. 또한, 테스트 데이터를 분석해 제조공정이나 조립공정에 피드백함으로써 제품의 질을 개선하는 역할도 합니다.
패키징 공정 관련주
한미반도체
1980년 설립후 제조용 장비의 개발 및 출시를 시작 함. 최첨단 자동화장비에 이르기까지 반도체 생산장비의 일괄 생산라인을 갖추고 세계적인 경쟁력을 확보 함.
고객사의 투자가 증가하는 추이를 보이고 있으며 EMI Shield 장비 부문에서도 한미반도체의 장비가 세계 점유율 1위를 기록하며 회사 가치 성장에 크게 기여하고 있음.
동사의 주력장비인 'VISION PLACEMENT'는 세계 시장 점유율 1위를 굳건히 지키고 있음.
- 동사는 반도체 초정밀금형 및 반도체 자동화장비의 제조 및 판매업 등을 영위할 목적으로 1980년 12월에 설립되었음.
- 반도체 제조용 초정밀금형 및 장비를 자체적으로 개발하여 국내외 반도체 소자업체 및 패키징업체에 공급하고 있으며, 확장ㆍ응용하여 태양광 장비, LED 장비 등도 개발 및 생산함.
- 대만 등 중화권에 대한 근접지원을 위해 해외법인인 Hanmi Taiwan Co., Ltd.를 연결대상 종속기업으로 보유하고 있음.
- 전방 반도체 산업의 업황 호조에 따라 주력인 패키징용 자동화 장비와 레이저 장비의 수주가 증가한바 매출 규모는 전년동기대비 크게 확대.
- 매출 급증에 따른 판관비 부담 축소로 영업이익률 전년동기대비 상승하였으며, 법인세비용 증가에도 지분법이익 증가 등으로 순이익률도 상승.
- 4차산업의 활성화 및 비메모리 공급 부족에 따른 투자 지속이 기대되며, 내재화한 Micro Saw의 VP 장비의 매출 본격화 등으로 외형 성장 및 수익성 향상 전망.

이오테크닉스
신제품 개발을 위해 기술연구소를 설립. 동사는 2000년 8월 24일 코스닥시장에 상장함.
동사의 레이저 응용기술은 반도체, PCB, Display, 휴대폰 산업의 경기와 밀접한 연관이 있음.
레이저 응용산업은 고객사의 주문에 의해서 제작되며 그 주문자별로 제품사양이 달라지는 특성상 대량생산이 어려운 산업으로서 장비에 사용되는 주요 구성품은 전문화된 생산업체에서 조달하고 있음.
- 동사는 1993년 12월에 설립되어 레이저마커 시스템과 레이저 응용기술 제품의 제조업을 주력사업으로 영위하고 있음.
- 레이저 기기를 제조하는 Eo-Technics Suzhou Co., Ltd와 PCB 레이저를 가공하는 레비아텍안산 등을 종속회사로 보유하고 있음.
- 레이저 마킹 분야를 시작으로 드릴링, 트리밍, 커팅 등 다양한 레이저 응용분야로의 진출을 확대하고 있음.
- 글로벌 경기 회복세와 전방 반도체 산업의 업황 호조로 레이저마커 및 응용기기의 수주 증가하며 매출 규모는 전년동기대비 확대.
- 양호한 매출 성장에 따른 원가 및 판관비 부담 완화로 영업이익률 전년동기대비 상승, 유형자산손상차손 발생 및 법인세비용 증가 등에도 순이익률 상승.
- 글로벌 OSAT 증설에 따른 마커의 수요 증가세 지속과 DRAM향 레이저 어닐링의 견조한 매출인식, 레이저 소스의 채택 확대 등으로 외형 신장세 유지할 듯.

심텍
동사는 인적분할로 설립된 신설 회사로 2015년 8월 재상장하였으며, 분할 전 회사인 심텍홀딩스의 인쇄회로기판 제조사업부문 일체를 영위.
글로벌 Big 4 메모리 칩 메이커인 삼성전자, SK하이닉스 등과 Big 5 패키징 전문기업 ASE, Amkor 등을 고객사로 확보하여 안정적인 성장을 지속 중임.
동사의 제품은 지속적인 기술개발을 바탕으로 선도기술인 패턴 매립형 기판(ETS)은 2016년 세계일류화 상품에 지정된 바 있음.
- 2015년 7월 (주)심텍홀딩스(구 (주)심텍)의 PCB 제조 사업부문이 인적분할되어 설립된 반도체 및 통신기기용 PCB 전문 제조업체임.
- 매출의 대부분이 수출(로컬 포함)이며 글로벌 메모리칩 메이커(삼성전자, SK하이닉스, 도시바, 샌디스크) 및 패키징 전문기업(ASE, Amkor, PTI 외)을 고객사로 확보.
- 주력품목인 메모리 모듈 PCB 위주의 사업에서 FC-CSP, MCP, BOC 등 성장성이 높은 반도체 패키지 Substrate 분야로 고객 확보 및 매출 확대 추진 중.
- Package substrate 수주 증가에도 모듈 PCB 수주 부진과, 중국, 싱가포르, 대만 등 해외 판매 부진으로 전년동기대비 매출 소폭 감소하였음.
- 판관비 부담 완화로 영업이익률 전년동기대비 소폭 상승하였으나, 영업외수지 저하와 법인세 증가로 순이익률은 전년동기대비 하락.
- 5G 투자 확대로 SiP 모듈 수요 증가, DDR5 전환으로 메모리 모듈 수요 증가, FP CSP 공급단가 상승, MSAP 기판의 생산능력 확대 등으로 매출 성장 전망.

대덕전자
동사는 인적분할로 설립된 신설회사로 2020년 5월 재상장하였으며 분할 전 회사인 대덕의 사업 중 PCB(인쇄회로기판) 사업부문을 영위하고 있음.
동사는 반도체 및 Mobile 통신기기 등 각 분야에 걸쳐서 첨단 PCB를 공급하고 있음.
4차 산업을 주도할 5G통신, 인공지능, 빅데이터 등의 기술에 요구되는 대용량, 다기능화, 초박판화에 대응하기 위해 선행기술을 확보하여 첨단 제품을 생산하고 있음.
- 동사는 2020년 5월 1일 (주)대덕(구. 대덕전자)의 PCB 사업부문이 인적분할되어 설립되었으며, 경기도 안산시 단원구에 본사를 두고 있음.
- 반도체용 PCB 전문 제조업체로 주요 매출처는 삼성전자, SK하이닉스, SKYWORKS, 엠씨넥스 등이며, 필리핀과 베트남, 중국에 종속기업을 두고 있음.
- 반도체 공정미세화, 서버 수요 증가, 고대역폭메모리 용량 증가 등으로 비메모리 반도체 시장이 확대 중인 바 신규 시설투자로 FC BGA 시장에 진출하였음.
- 글로벌 경기 회복세와 비대면 트렌드 지속에 따른 PCB 수요 증가, 신규 전장 부품향 비메모리인 FC BGA의 매출 본격화로 급격한 매출 성장세 보임.
- 원가 및 판관비 부담 완화로 영업이익률 전년동기대비 상승, 중단영업손실 기록에도 영업외수지 개선되며 순이익은 전년동기대비 흑자전환.
- 차량 전장화 확대 추세로 FC BGA 부문의 높은 성장세 및 투자 확대, PC, 컨솔, 데이터센터향 PCB 수요 증가, 주요 고객사들의 증설 영향 등으로 매출 성장 전망.

참고 : 삼성반도체이야기, 네이버금융, NICE
'종목공부' 카테고리의 다른 글
| 리메드(302550) - 기업분석 및 주가 전망 (0) | 2022.03.14 |
|---|---|
| 티앤엘(340570) - 기업분석 및 주가 전망 (0) | 2022.03.13 |
| 반도체 8대 공정⑦ - EDS공정, 관련주 (0) | 2022.03.01 |
| 반도체 8대 공정⑥-전기가 통하는 길을 만드는 ‘금속 배선 공정’, 관련주 (0) | 2022.02.28 |
| 반도체 8대 공정⑤-반도체에 전기적 특성을 입히다! 증착&이온주입 공정, 관련주 (0) | 2022.02.27 |



